2018年,Nexperia发布了首款NextPower 100 V MOSFET,该器件具有行业领先的低Qrr。近期新推出的80 V和100 V器件进一步改善了RDS(on)并增强了Qrr FOM(品质因数)。NextPower 80 V和NextPower 100 V MOSFET 一系列产品非常适用于各种高性能开关应用。但是,为什么设计工程师应该重视Qrr和Vds?
正如Qrr:在效率之争中被忽视和低估中所述,Qrr可能会对效率和尖峰产生重大影响。但通常您会发现Qrr(和Trr)列在数据表底部。Qrr是指当二极管正向偏置时,在MOSFET的体二极管PN结中累积的电荷量。放电需要时间,可能会产生明显的瞬态电流(Irr),通常为几十安培,持续几十纳秒,从而导致电路的其他部分出现I2R损耗。此外,它与寄生电感相互作用,导致漏极-源极电压(Vds)产生有问题的电压尖峰。因此,低Qrr MOSFET变得越来越重要。
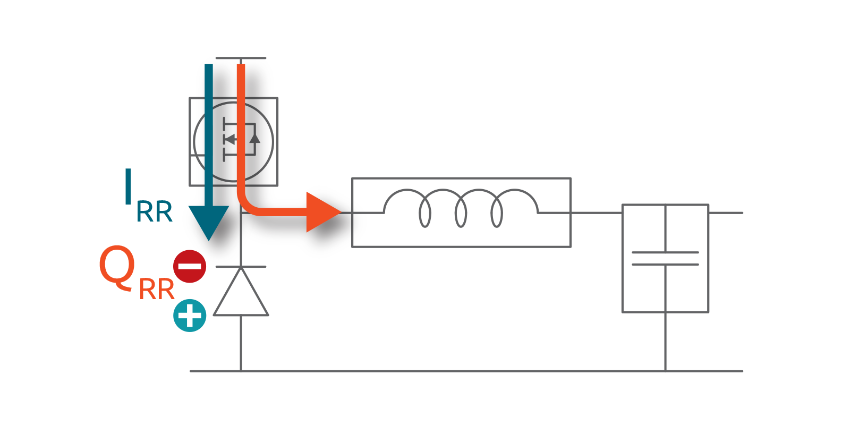
体二极管的作用
MOSFET的体二极管能够让感性负载电流在MOSFET处于“关断”状态时绕开MOSFET。因此,它在同步整流(AC-DC和DC-DC)和电机控制(全桥和半桥)等许多应用中都是一个重要特性。在一个MOSFET关断和第二个MOSFET导通之间的“死区时间”内,体二极管会导通。虽然死区时间通常很短暂(约80至100纳秒),但与这部分开关周期相关的损耗可能非常大。与体二极管导通阶段相关的能量损耗机制主要有两种。
因Vf引起的体二极管损耗
我们来比较因体二极管的正向电压Vf引起的损耗与理想4 mΩ MOSFET在80 ns内产生的损耗。首先,考虑让20 A标称负载电流流经理想MOSFET,I2R功耗为1.6 W,因此80 ns内产生的总能耗为0.128 µJ。
现在,考虑让20 A负载电流流经Vf为1.2 V的典型体二极管。瞬时功耗为24 W。如果死区时间为80 ns,则由于体二极管Vf引起的能耗为1.92 µJ。因此,当电流通过体二极管时,损耗比理想状态高15倍。但是,将Vf降至1 V后,因体二极管Vf引起的能耗为每个开关周期1.6 µJ,或者说只高出12倍。
因Qrr引起的体二极管损耗
同样,当我们考虑理想的4 mΩ高边MOSFET(Qrr为0 nC)时,I2R功耗为1.6 W。因此,如果负载电流持续流动40 ns(Trr典型值),则能耗为64 nJ。
然后,考虑Irr为20 A的三角波电流,同样持续Trr,则高边MOSFET因Qrr引起的额外功耗为32 nJ [((202 x 0.004) x 40 x 10-9) / 2]。因此,将Qrr降低50%可以使每个开关周期的能耗减少16 nJ,有助于最大限度地减少高边MOSFET的I2R损耗。
削减死区时间
为避免电源轨之间出现交叉导通电流(击穿),需要通过死区时间设置来确保两个MOSFET永远不会同时导通。通常被设置应为MOSFET振铃衰减至安全水平提供充足的时间。但是,低Qrr MOSFET的峰值电流更低,尖峰持续时间更短。因而振铃/谐振减少,这有利于减少EMI,同时为设计工程师提供了缩短死区时间的选项,可进一步提高效率。
LFPAK保持领先
Nexperia的新型NextPower 80 V/100 V低Qrr MOSFET针对Qrr进行了全面优化改进。结合使用LFPAK的铜夹结构,可最大限度减少PCB和器件引线框架中的寄生电感,并通过进一步降低Irr,能够将客户应用中的最大尖峰电压减少约10 V至20 V,使测量的EMI排放降低多达10 dB。与典型竞争对手产品的1.1至1.2 V相比,经过改进的Vsd (max)为1 V,可降低因Vf引起的体二极管损耗。
