我们知道与大多数人成长过程中所乘坐的传统汽车相比,今天的汽车更接近于轮子上的电子产品 -- 尽管我们曾经对其引擎盖下的内部工作和控制感到惊叹,但现代汽车已将其变为复杂的计算机。近年来,随着设计人员寻求减轻重量、提高可靠性、简化车辆组装、创造差异化功能以及实施先进的驾驶辅助和自动驾驶系统,我们所看到的持续不断的电气化继续延伸到整个车辆,更不用说传动系统发生了什么。
在这一趋势之初,当电气化仅限于某些车辆功能时,基于域的控制方法就显得非常有意义。然而,随着软件数量的增加和软件故障风险的增加,对软件可升级单元的需求变得明显。各种各样的 ECU 组合所带来的复杂性进一步加剧了挑战,几乎不可能实施有效的升级。这导致了众多电子控制单元 (ECU) 的集成,以处理扩展的功能,从而导致某些车辆包含 100 多个此类模块。尽管空间非常有限,但它们都需要安装在车辆结构中的某个位置。布线也变得复杂和笨重,与减轻重量和提高可靠性的目标背道而驰。
如今,越来越多的汽车功能被专用ECU所集成,这种分区架构如今很受欢迎,可减少ECU数量并简化布线,这种各种功能集合的ECU架构可以降低成本。然而,与任何工程挑战一样,有得必有失,将多种不同功能整合进更少的ECU中可能会使其变得过于庞大、笨重和耗电,我们自然不愿妥协。

从分布式到现代汽车区域E/E架构的发展。
车辆基础设施中的功率半导体
工程师和设计人员已经借鉴电子行业的传统方法应对这一挑战:提高半导体集成度并使用复杂的多层衬底以缩小元件间距,从而减少PCB和设备的尺寸。
然而,额外电路的加入也推升了每个ECU的典型功率需求。由于空间有限,电源电路必须更小,而处理的功率却更大,这就提高了功率密度,并要求增加散热,以防止过热和ECU早期故障。
在其他行业,设计人员迅速采用先进的电源转换拓扑结构,利用同步整流和零电压开关等技术提高效率并减少散热。然而,在汽车领域,成本、可靠性、耐用性等因素占据主导地位,设计人员往往倾向于采用更保守、更成熟的方案,如异步降压、升压和SEPIC转换器。因此,虽然功率密度的压力促使元件供应商开发出尺寸更小的封装,但元件的散热量必须保持不变。
晶体管和整流二极管需要新型半导体封装,既节省空间,又具有极高的热效率。在许多代产品中,设计人员一直依赖于SOT23和SMx(SMA、SMB、SMC)等现有的封装方式,但随着需求的快速迭代,目前急需散热能力更强的新型封装。
底层创新:新一代封装如何实现高效散热
但是,新一代封装的对手是什么?SOT23是各行各业最常用的晶体管和二极管表面贴装封装之一,这种引线式封装将裸片连接到引线框架上,通常直接连接到源极,而焊线则连接到栅极和漏极引线上。而顾名思义,DFN(分立扁平无引线)结构不含引线,其底部采用双排接线端子,间距很近,可以缩短焊线,
从而降低封装电感、无裸片封装电阻(DFPR)和热阻,提高电气性能。在现有的SOT23中,内部产生的热量必须通过裸片粘接层到达引线框架,并沿着源引线到达衬底,相比之下,更先进的DFN可将热量从芯片直接向下传导至封装底部的源极焊盘,更短的路径可确保更高效的散热。
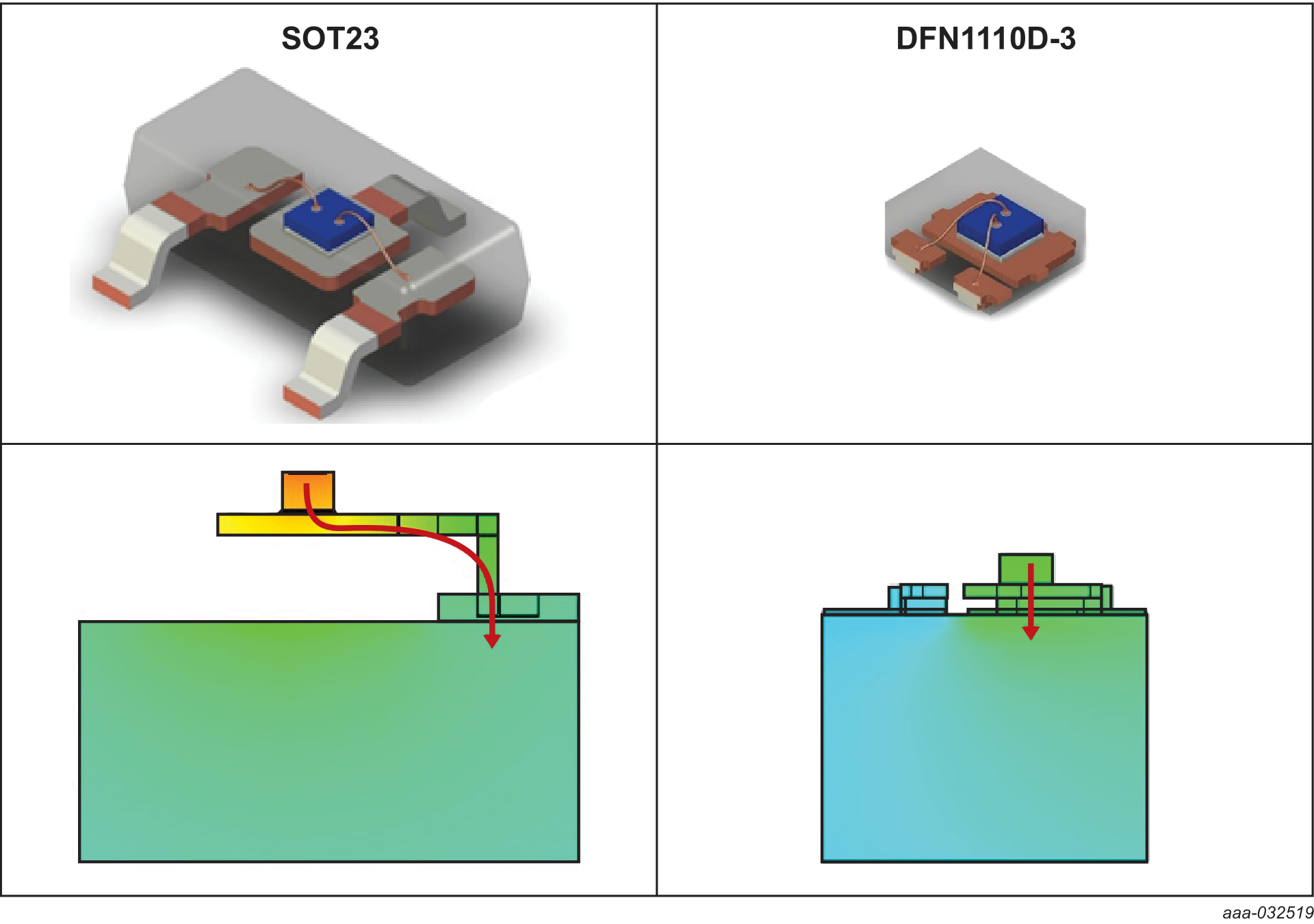
SOT23和DFN封装的内部视图和散热路径
功率二极管在开关转换过程中会通过大量电流,因此功率电路的设计人员希望改善其散热性能。SMx封装多年来一直是设计人员的首选,现在正逐渐让位于铜夹片(CFP)等新型封装。与类似额定值的SMx相比,CFP封装可节省38-75%的PCB面积,同时具有同等或更优的功率处理能力。以W/cm²为单位,散热能力大幅提升。
CFP封装性能的提高主要归功于我们的铜夹片技术,该技术可替代传统的焊线技术。20多年前,我们首次推出无损封装LFPAK并将这一技术推向市场,这一重大创新令经验丰富的电路设计人员难以置信,他们惊讶于这一小型封装所具备的强大的功率处理能力,而这一技术的关键在于可增强芯片顶部和底部散热效果的铜夹片。与普通的焊线连接相比,顶部连接的表面积更大,从芯片到PCB的散热路径更短,而夹片的大横截面面积可确保热量有效传导至封装底部和衬底。
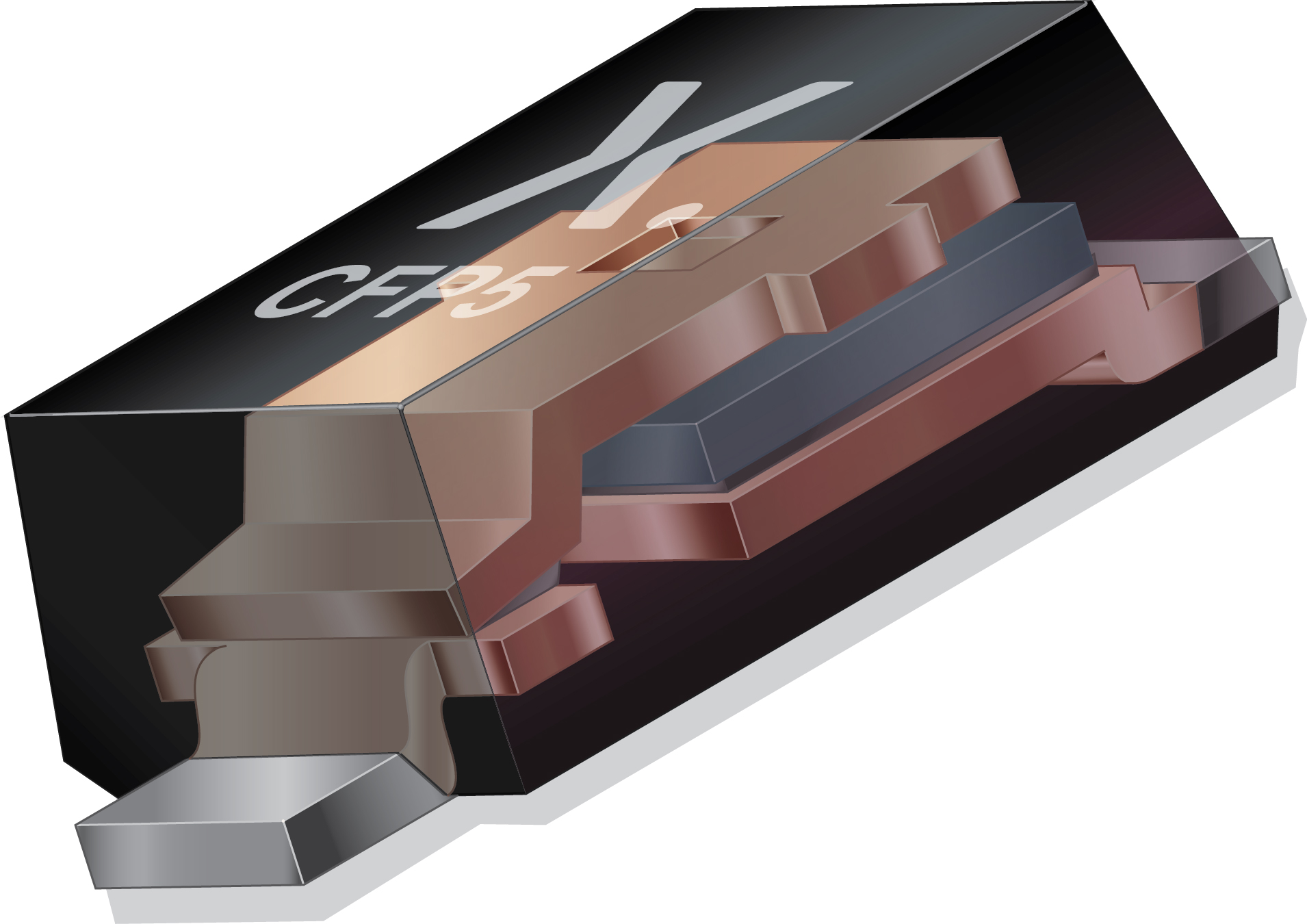
铜夹片封装(CFP)内视图
小体积,大改进:CFP和DFN更具性价比
目前,汽车应用领域普遍要求节省空间、高热效率的封装,包括LED照明系统、牵引逆变器、电池管理系统(BMS)和大功率车载充电器(OBC)。DFN将成为小信号二极管和晶体管的首选方案,未来,CFP也将成为功率二极管的最佳封装方式。这种转变正在发生,我们已经开始投资提高生产能力。
我们迫切需要新的封装类型。现代汽车的计算能力不断提高,也需要引脚数较多的MCU,因此多层PCB是正确布线的先决条件。这些PCB的成本较高,因此需要使用具有相同电气性能的较小尺寸封装。即使小型封装解决方案可能会提高零件成本,但系统成本的降低将证明采用CFP和DFN封装是明智之选。
不过,在许多情况下,小型封装本身就能减少零件成本。生产线已证明此类封装更具成本效益,因为封装成本与封装尺寸成反比。我们看到,CFP封装在生产成本方面优于SMx、DPAK、TOx等传统封装方式,我们预测DFN封装也是如此。
现代汽车和工业应用不断增长的需求推动零部件市场的发展,并对价格和供应产生了影响。需求将超过SMA、SMB、SMC等“传统”封装的供应和可用性,这将迫使设计人员采用性能更优的替代方案,以适应未来产品的需求。
总结
如今,电子产品市场呼唤更小、更强大、更可靠的汽车ECU,好在最新的高效封装技术使这一切成为可能,大大减少了功率晶体管和功率二极管的尺寸,同时促进了散热。
Nexperia将继续大力投资扩大产能,以满足日益增长的市场需求,特别是汽车和工业应用领域对CFP和DFN封装产品的需求。通过将多种版本的器件推向市场,我们强调了扩大产能、加快向体积更小和优化热性能封装过渡的承诺。
了解如何利用Nexperia的CFP和DFN封装二极管和晶体管为您的设计节省PCB空间和面向未来,请访问nexperia.com/save-pcb-space